
Introduction
Below 10 nm, conventional lithography runs out of room. Optical and electron beam lithography (EBL) both hit hard physical limits: electron scattering in resists creates proximity effects that blur pattern edges, while extreme ultraviolet (EUV) lithography struggles with stochastic photon shot noise and demands extraordinarily complex source and mask infrastructure. Research confirms that EBL resolution is practically limited to 10–20 nm for dense periodic features due to severe electron backscattering in substrates.
Helium ion beam lithography (HIBL) addresses these limits by using focused beams of helium ions — rather than electrons or photons — to pattern nanoscale features. With demonstrated 4–5 nm half-pitch resolution and a proximity effect roughly two orders of magnitude lower than EBL, HIBL now serves as a critical tool for research prototyping, EUV resist screening, and quantum device fabrication.
This article explores how HIBL works, compares it technically to EBL and EUV, examines breakthrough resist materials enabling sub-10 nm patterning, highlights real-world applications across semiconductors and 2D materials, and addresses the throughput and substrate damage limitations that currently confine HIBL to research and high-value niche markets.
TLDR
- HIBL uses focused helium ions—not electrons or photons—to pattern features smaller than 10 nm in resist films
- Its sub-nanometer spot size and proximity effect roughly 50–100× lower than EBL enable pitch-independent feature sizing down to 6 nm dots at 14 nm pitch
- Specialized resists such as HSQ and fullerene derivatives show 60–500× greater sensitivity to helium ions than to electrons
- Key applications include semiconductor device prototyping, EUV resist pre-screening, nanoimprint template fabrication, and 2D material patterning
- Major limitations—low throughput and helium implantation damage—restrict HIBL to research-scale patterning rather than high-volume manufacturing
What Is Helium Ion Beam Lithography and How Does It Work?
The Fundamental Mechanism
HIBL operates using a scanning helium ion microscope (SHIM), such as the Carl Zeiss ORION PLUS, which generates a focused beam of He⁺ ions accelerated to approximately 30 keV. This beam is rastered point-by-point across a resist-coated substrate. When helium ions strike the resist, they chemically modify it through secondary electron generation—the ions transfer energy to electrons in the resist material, which either cross-link polymer chains (in negative-tone resists) or cleave them (in positive-tone resists). After exposure, the developer solution selectively washes away either the exposed or unexposed areas, leaving behind the desired nanoscale pattern.
Why Helium Ions Outperform Electrons
Helium ions are approximately 7,300 times heavier than electrons. When a helium ion encounters electrons in the resist or substrate, it barely changes trajectory—the ion plows straight through with minimal lateral scattering.
Electrons behave very differently. They scatter widely when they collide with atomic nuclei and other electrons, creating a "halo" of unintended exposure around the beam landing point.
This scattering phenomenon is called the proximity effect—when a charged beam spreads laterally in the resist and substrate, it unintentionally exposes areas away from the intended pattern, causing blurring and loss of resolution. Studies comparing HIBL and EBL directly show that HIBL exhibits a proximity effect approximately two orders of magnitude lower than EBL, enabling HIBL to maintain sharp pattern edges even at extremely dense pitches.
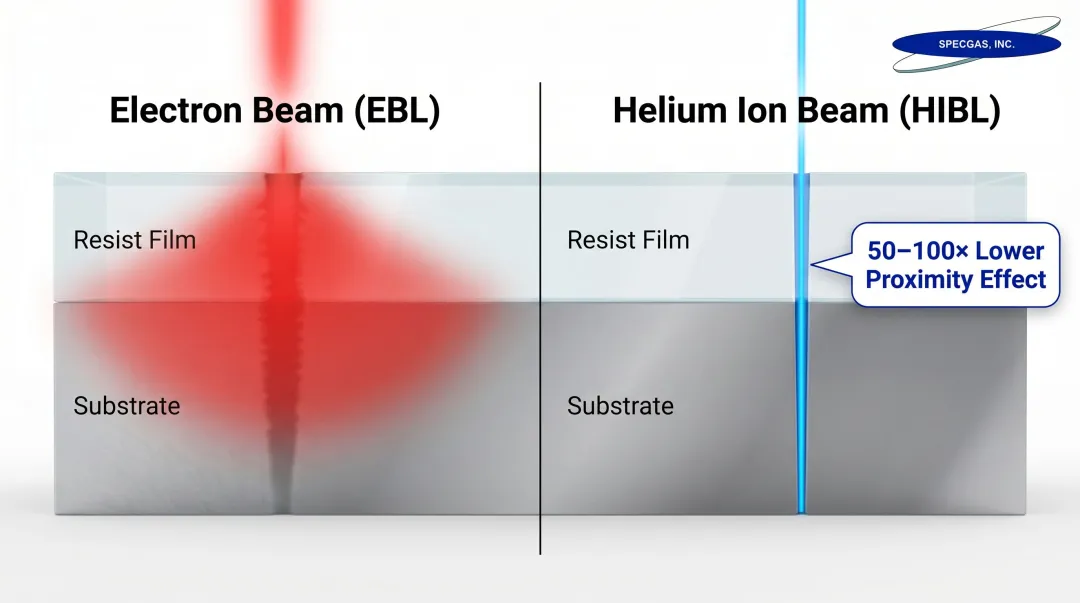
Gas Field Ion Source (GFIS) Technology
Gas Field Ion Source (GFIS) technology is what makes sub-nanometer focusing possible. Refined since the first commercial SHIM was delivered to the U.S. National Institute of Standards and Technology (NIST) in 2007/2008, GFIS allows the helium ion beam to be focused to a probe size of 0.5 nm or smaller—far below what any conventional EBL system can achieve. This ultra-fine probe is the foundation for HIBL's ability to write features at the single-digit nanometer scale.
The Role of Ultra-High Purity Helium
Reproducible HIBL operation depends on ultra-high purity helium feed gas. Beam quality is directly tied to the purity grade of the supply—impurities can degrade the GFIS tip, reduce beam brightness, and introduce dose variability. For research labs running HIBL systems, this means sourcing matters.
Specialty gas suppliers like SpecGas Inc. provide NIST-traceable high-purity helium using proprietary internal cylinder treatment processes that maintain gas stability and prevent contamination across extended storage periods—an important practical consideration for labs where beam consistency is non-negotiable.
Secondary Electron Generation and Resist Sensitivity
HIBL's resist sensitivity advantage comes down to secondary electron generation. Monte Carlo SRIM simulations confirm that ionization accounts for more than 93% of a 30 keV He⁺ ion's energy loss in typical resist films. This massive energy transfer produces roughly 250 secondary electrons per ion in a ~20 nm resist layer.
These secondary electrons are what actually activate the resist—breaking or cross-linking polymer chains. Because helium ions generate far more secondary electrons per incident particle than electron beams do, HIBL achieves significantly higher resist sensitivity than EBL.
HIBL vs. EBL vs. EUV: A Technical Comparison
Spot Size and Resolution
HIBL achieves sub-nanometer beam spot sizes, enabling demonstrated feature sizes of 4–5 nm half-pitch in HSQ resists and sub-10 nm lines in multiple resist systems. By comparison, EBL is typically limited to ~10–20 nm resolution due to electron scattering, even with high-energy (100 keV) beams. EUV lithography operates at a 13.5 nm wavelength and, while it achieves high throughput with systems exceeding 140 wafers per hour, faces resolution limits imposed by numerical aperture (NA) constraints and stochastic photon shot noise.
Proximity Effects
Proximity effect is one of HIBL's most decisive advantages over competing techniques. Studies using ring-pattern arrays show that HIBL exhibits a proximity effect approximately 50–100× lower than EBL. This dramatic reduction means that feature size in HIBL remains essentially pitch-independent even at very high pattern densities. For example, researchers have fabricated 6 nm diameter dots at a dense 14 nm pitch in thin HSQ films—a feat that would be impossible with EBL due to overlapping proximity halos from adjacent beam positions.
That reduced proximity effect also has a direct consequence for resist exposure: because less energy bleeds into surrounding areas, the resist receives a cleaner, more localized dose—which connects directly to HIBL's sensitivity advantage.
Resist Sensitivity
HIBL requires dramatically lower exposure doses than EBL:
- PMMA (positive-tone resist): ~60× lower dose for HIBL (~2 μC/cm²) compared to EBL (~120 μC/cm²)
- Fullerene-based resists: Up to 500× lower dose for HIBL (~40 μC/cm²) vs. EBL (~20,000 μC/cm²)
The physical basis for this sensitivity gain is the He-ion-to-electron stopping power ratio, which ranges from 50–100× across common resist materials. This means each helium ion deposits 50–100 times more energy in the resist than an electron does, enabling faster exposures and better throughput at the single-beam level.
Higher energy deposition per ion also influences substrate interactions—which brings in a critical tradeoff that varies across all three techniques.
Damage Profiles
Each lithography technique carries different substrate damage risks:
- EBL — Minimal substrate damage; electrons deposit relatively little energy and do not implant into the substrate
- Gallium FIB — Severe ion implantation and sputtering damage; gallium ions are heavy, sputter material aggressively, and become embedded in the substrate, altering electrical properties
- HIBL — Middle ground; helium ions penetrate deeply (~hundreds of nm at 30 keV) with lower sputtering yield than gallium, but subsurface helium bubble formation at high doses is a real concern
- EUV — No ion implantation issue, but faces mask defect sensitivity and requires ultra-high vacuum and complex multilayer reflective optics
Comparative Summary
The table below synthesizes the key performance parameters across all three techniques:
| Metric | EBL | EUV | HIBL |
|---|---|---|---|
| Spot Size | ~1–2 nm | 13.5 nm wavelength | <0.5 nm |
| Minimum Feature Size | 10–20 nm half-pitch | 8–13 nm (0.33–0.55 NA) | 4–5 nm half-pitch |
| Proximity Effect | High (micron-scale backscatter) | Negligible (secondary electron blur) | Ultra-low (~50–100× < EBL) |
| Throughput | Low (serial writing) | High (>140 WPH) | Very low (serial writing) |
| PMMA Sensitivity | ~120 μC/cm² | N/A | ~2 μC/cm² (~60× lower) |
| Substrate Damage | Minimal | None (photon-based) | Moderate (helium implantation risk) |

Recent Advances in Resist Materials for HIBL
Traditional Organic Resists
PMMA (polymethyl methacrylate) can function as both positive- and negative-tone resist under HIBL, switching behavior at very high doses. Its well-characterized chemistry and ease of processing make it a standard benchmark for HIBL research.
HSQ (hydrogen silsesquioxane) is a negative-tone resist that has yielded some of the smallest features ever achieved with HIBL. Researchers have patterned 4–5 nm half-pitch lines in 12 nm thick HSQ films, demonstrating the ultimate resolution potential of the technique. HIBL's high sensitivity allows HSQ to be exposed at far lower doses than in EBL, improving process efficiency and reducing substrate damage.
Inorganic and Metal-Oxide Resists
HafSOx (hafnium oxosulfate) has become a prominent inorganic negative-tone resist for both HIBL and EUV applications. HafSOx achieved a turn-on dose (D₁₀₀) of ~2–4 μC/cm² with HIBL—nearly 100× more sensitive than with EBL—and demonstrated sub-10 nm line widths with low line-edge roughness (LER ~2.9 nm, 3σ).
The small cluster-based structure of inorganic resists (molecular clusters ~2 nm in size) inherently enables lower LER and higher resolution compared to long-chain polymer resists like PMMA, where polymer chain length and entanglement introduce granularity.
Novel Molecular Resists: Fullerenes
Fullerene-derived resists (C60 and derivatives) benefit from an extremely small molecular size (~1 nm), which minimizes the granularity that causes roughness in polymer resists. Fullerene resists are up to 500× more sensitive to helium ions than to electrons, and have produced 8.5 nm lines at 17 nm pitch, placing them at the forefront of sub-10 nm HIBL patterning research.
Organic-Inorganic Hybrid and Organometallic Resists
Recent work on tin-based organometallic resists and metal-organic cluster resists (such as zinc-oxo clusters) has shown sub-13 nm patterning capability. Nickel-based metal-organic clusters (Ni-MOC) have achieved ~9 nm HIBL line patterns with uniform cluster sizes around 2 nm. These hybrid materials combine the high absorption and sensitivity of metal atoms with the processability of organic frameworks, and are being developed for both HIBL and EUV applications.
Line-Edge Roughness (LER) and Line-Width Roughness (LWR)
LER measures the 3σ deviation in the position of a feature edge from its ideal straight line, while LWR measures the 3σ deviation in line width along its length. Both metrics are critical for device performance, as excessive roughness causes variability in transistor threshold voltage and reduces yield.
HIBL generally achieves competitive LER values compared to EBL for the same feature sizes, but further resist optimization (particularly in developer chemistry and film thickness) is an active area of research. Meeting sub-3 nm LER targets for future device nodes will require advances in resist molecular design and process control.

Key Applications of HIBL Across Industries
Semiconductor Device Prototyping and Research
HIBL is currently most widely used as a research and prototyping tool for next-generation semiconductor devices. Researchers have demonstrated the fabrication of sub-10 nm gate-length junctionless transistors, including ferroelectric Si transistors with gates defined by HIBL, proving its device-level capability.
HIBL also plays a valuable role in EUV resist pre-screening. Because the secondary electron energy distribution generated by 30 keV He⁺ ions closely mimics that of 13.5 nm EUV photons, HIBL can accurately predict EUV resist performance before committing to expensive EUV scanner exposure. Semiconductor labs can evaluate candidate resists like HafSOx in a tabletop SHIM system — faster and at far lower cost than EUV production trials.
2D Materials, Photonics, and Quantum Device Fabrication
HIBL's minimal proximity effect and sub-nanometer resolution make it well matched for nanopatterning delicate 2D materials such as graphene, MoS₂, and other transition metal dichalcogenides (TMDs). Unlike heavy ion focused ion beams (FIB) that cause severe sputtering and implantation damage, HIBL enables precise patterning without compromising the electronic properties of atomically thin materials.
Applications include:
- Monolayer MoS₂ nanoribbon field-effect devices for next-generation transistor research
- 5 nm graphene nanoribbons for quantum transport studies
- Photonic crystal structures with sub-10 nm feature control for optical metamaterials
- Plasmonic nanogap antennas with gaps below 10 nm for surface-enhanced spectroscopy
- Superconducting qubit components for quantum computing research
Nanoimprint Template Fabrication and Biomedical Microfluidics
HIBL-patterned masters in HSQ or other hard resists can serve as templates for nanoimprint lithography (NIL), enabling high-volume replication of sub-10 nm features without repeated ion beam exposure. Combined HIBL and NIL has achieved 4 nm half-pitch dense patterns in UV-curable resists, showing how HIBL's resolution advantages can scale to larger production volumes.
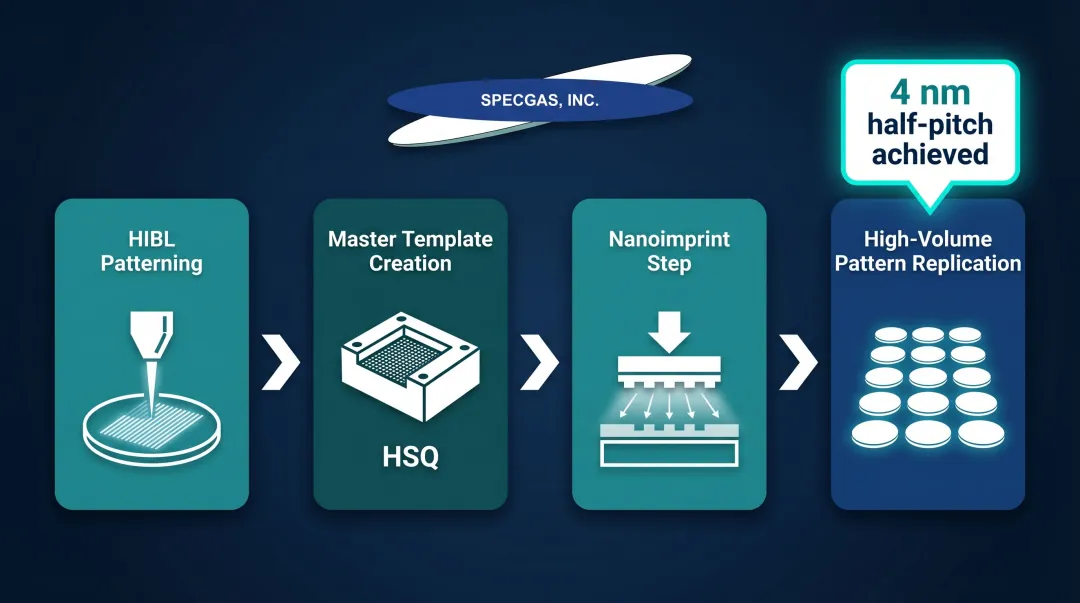
Researchers are also applying ion beam patterning of polymer substrates (such as cyclic olefin copolymer, COC) to create selective cell adhesion surfaces for microfluidic lab-on-chip devices. By modifying surface wettability through controlled ion exposure, researchers can guide cell attachment and growth patterns for biomedical diagnostics and tissue engineering applications.
Challenges and Future Outlook for HIBL
Throughput and Cost Limitations
HIBL is inherently a serial (single-beam, point-by-point writing) technique, making it far slower than parallel optical or EUV lithography for large-area patterning. EUV systems can process over 140 wafers per hour; a single-beam HIBL system might take hours to pattern a single square millimeter at high resolution. This throughput bottleneck limits HIBL's practical use to:
- Prototyping and low-volume device research
- Mask and template fabrication
- Niche applications where resolution outweighs speed
Multi-beam ion lithography (MBIL) is the most active research path toward closing this gap. Researchers are investigating prototype systems using liquid metal alloy ion sources (LMAIS) and ExB mass filters to deliver multiple ion species in parallel, though commercial availability and resolution performance remain to be demonstrated.
Helium Implantation and Subsurface Damage
A critical limitation of HIBL is the potential for helium bubble formation in substrates at high ion doses. Research shows that helium ions have low solubility in silicon and migrate to form nanobubble clusters. At doses around 1×10¹⁶ ions/cm², lattice dislocations begin to appear. Increasing the dose to 5×10¹⁷ ions/cm² causes silicon to become completely amorphous, forming porous bands of helium nanobubbles ranging from 1 to 30 nm in diameter.
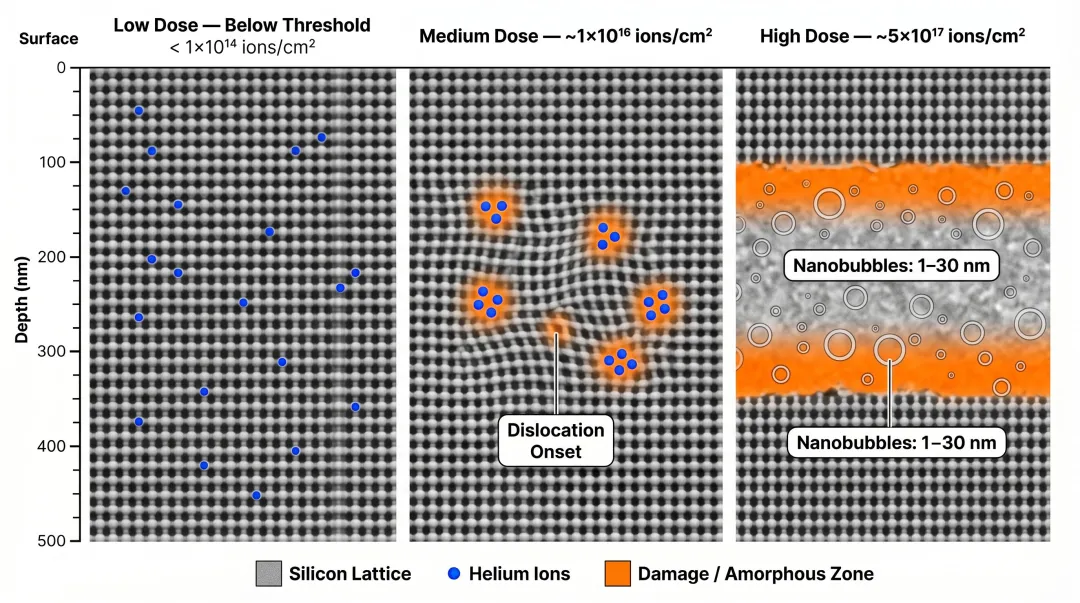
Current mitigation strategies include:
- Using HIBL only for resist patterning, with subsequent pattern transfer (etching) to avoid further ion exposure of the device layer
- Employing ultrathin resist films to reduce the required exposure dose
- Annealing steps to release trapped helium before device processing
- Limiting exposure doses to below the damage threshold for the specific substrate material
Future Directions: Neon Ion Beams and Beyond
Advances in gas field ion source technology are expanding the technique to neon ion beam lithography (NIBL). Neon ions offer higher stopping power and sputter yields than helium, enabling faster resist exposure and direct substrate machining. NIBL has demonstrated lithography resolutions down to 7 nm half-pitch, though the neon beam achieves a larger probe size (~1.9 nm) compared to helium's ~0.5 nm.
Looking ahead, HIBL is positioned as a complement to EUV for sub-5 nm research-scale patterning — particularly in mask repair, 2D-material device prototyping, and quantum device fabrication where feature density matters more than wafer throughput. Throughput constraints will keep it out of high-volume manufacturing, but that's not where its value lies. As neon and potentially hydrogen beam sources mature, the focused ion beam toolkit will continue expanding the resolution floor for next-generation device research.
Frequently Asked Questions
What is the difference between EUV and EBL?
EUV uses 13.5 nm wavelength light through a reflective mask to expose an entire wafer in parallel — ideal for high-volume chip production. EBL writes patterns serially with a focused electron beam, trading throughput for higher resolution and mask-free flexibility, making it the preferred tool for research, prototyping, and photomask fabrication.
What are the three types of lithography?
Optical lithography uses UV/DUV/EUV light through photomasks and dominates high-volume production. Charged particle beam lithography — including electron beam and ion beam methods like HIBL — delivers finer resolution for research and specialty work. Nanoimprint lithography physically presses a mold into resist to transfer patterns at low cost.
What resists are used in helium ion beam lithography?
The main classes are polymeric resists (PMMA, HSQ), inorganic resists (HafSOx, metal-oxide clusters), molecular resists (C60 derivatives), and organometallic hybrids. All respond to helium ions at 60–500× lower doses than electrons, enabling faster writing with less substrate damage.
How does HIBL achieve sub-10 nm resolution?
The helium ion beam can be focused to a spot smaller than 0.5 nm (roughly 5–10× smaller than a typical focused electron beam spot), and helium ions scatter far less laterally in the resist than electrons do—reducing the proximity effect by roughly 50–100×. This allows patterns to be written with extremely tight spatial control down to the single-digit nanometer scale.
What is the proximity effect in lithography?
The proximity effect occurs when a charged beam (electrons or ions) scatters within the resist and substrate, unintentionally exposing resist areas away from the intended beam landing point—causing blurring and loss of resolution. HIBL reduces this effect by approximately two orders of magnitude compared to EBL because the heavier helium ions scatter far less laterally.
What are the main limitations of helium ion beam lithography?
HIBL's main limitations are serial throughput (orders of magnitude slower than EUV), helium implantation that can cause subsurface bubble damage at high doses, and the high capital cost of helium ion microscope systems. These factors currently confine HIBL to research and prototyping rather than mass production.


